在8月下旬于美国矽谷举行的年度Hot Chips大会上,Intel与Xilinx分享了晶片堆叠技术的最新进展.美国的一项研究专案旨在培育一个能以随插即用的「小晶片(chiplet)」来设计半导体的生态系统;而在此同时,英特尔(Intel)和赛灵思(Xilinx)等厂商则是使用专有封装技术,来让自己的FPGA产品与竞争产品有所差异化。
在未来八个月,美国国防部高等研究计画署(DARPA)的「CHIPS」(Common Heterogeneous Integration and Intellectual Property Reuse Strategies)专案,期望能定义与测试开放晶片介面(open chip interfaces),并在三年内让许多公司运用该连结介面来打造各种复杂的零组件。
英特尔已经参与此项专案,其他厂商预计也会马上跟进;这位x86架构的巨擘正在内部争论是否要公开部份的嵌入式多晶片互连桥接技术(embedded multi-die interconnect bridge,EMIB),而在8月下旬于美国矽谷举行的年度Hot Chips大会上,英特尔公布了目前EMIB技术的大部分细节。
有机基板(organic substrate)的多晶片模组(MCM)已经行之有年,除了相对较低密度的问题,有些供应商正在想办法降低成本。台积电率先推出了一种扇出型(fan out)晶圆级封装,用来封装苹果(Apple)最新iPhone手机中的应用处理器及其记忆体,该技术提供比多晶片模组技术更大的密度,但用来连结处理器仍不够力。
如同微软,AMD的Epyc伺服器处理器不考虑采用相对昂贵的2.5D 堆叠技术,此处理器是由有机基板上的四颗裸晶(die)所组成。在Hot Chip大会上介绍该晶片的AMD代表Kevin Lepa表示:「较传统的多晶片模组是较为人知的技术,成本更低…某些方面(效能)会有所牺牲,但我们认为这是可以接受的。」
一些人希望DARPA的研发专案能尽速解决复杂的技术与商业瓶颈,Xilinx的一位资深架构师即表示:「我们希望小晶片能变成更像是IP。」
在2014年,英特尔首先将其EMIB技术形容为功能媲美2.5D堆叠技术、但成本更低的方案,某部分是因为它只使用一部份的矽中介层(silicon-interposer)来连接任何尺寸的裸晶两端。 Altera在被英特尔并购前尝试过该技术,其现在出货的高阶Stratix FPGA使用EMIB来连结DRAM堆叠与收发器。
EMIB介面与CCIX进展
在Hot Chips大会上,英特尔介绍了两种采用EMIB技术的介面,其一名为UIB,是以一种若非Samsung就是SK Hynix使用的DRAM堆叠Jedec连结标准为基础;另外一个称作AIB,是英特尔为收发器开发的专有介面,之后广泛应用于类比、RF与其他元件。
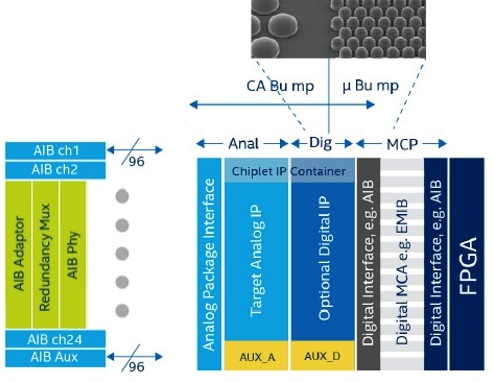
英特尔与Xilinx都提到了设计模组化晶片时所面临的一些挑战。 CoWoS制程要求晶片的最大接面温度维持在摄氏95度以下;Singh提到,DRAM堆叠每减少一层,温度大约会提高两度;Shumarayev则表示,英特尔要求晶片供应商为堆叠出货的裸晶都是KGD (known good die),因为封装坏晶粒的成本问题一直是多晶片封装市场的困扰。
编译:W. Lin;责编:Judith Cheng
参考原文:Hot Chips Spotlights Chip Stacks,by Rick Merritt
(文章来源:EET 电子工程专辑 )
关注行业动态,了解产业信息,以实现与时俱进,开拓创新,稳步发展。
标签: 晶片 EMIB CCIX



